傅立葉轉換紅外光譜技術於晶圓碳氧含量鑑定
晶圓生成介紹
大多數用於半導體生產的矽晶圓片是從透過 Czochlarski (CZ) 方法生長的單晶切割而成的。在生成的過程中,氧氣和碳從石英坩堝和石墨加熱器中不同程度地被引入熔融矽中。當圓錠從熔體中拉出並且讓矽凝固時,這些雜質被摻雜結合到晶格中。因為碳原子佔據晶格結構中通常由矽原子佔據的位置,所以這種類型的雜質被歸類為置換雜質。此外,氧原子也可以在矽原子之間的晶格結構內找到位置,形成所謂的間隙雜質。
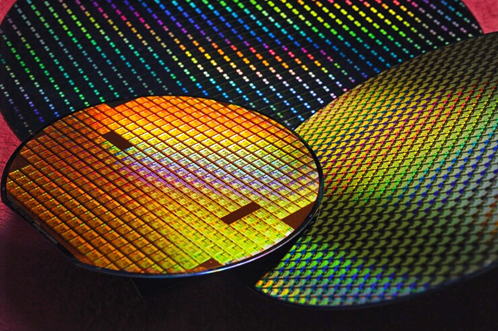
圖1. 矽晶圓(Wafer)
不同層級的間隙氧(OI)會造成不同物理或電效應上的影響。為了避免這些因素的干擾,在生成晶圓時,需要監測控制這些間隙氧(OI)的濃度。儘管尚未證實置換碳(CS)是否影響晶圓的品質,但許多實驗表明置換碳(CS)的濃度會影響加熱矽時間隙氧(OI)的行為方式,例如在典型的矽加工溫度循環中就會發現這種現象。
間隙氧(OI)存在於氣/固溶液中,加熱時會發生變化。氧氣溶解在高於熔點1,410度C的熔融矽中。當矽冷卻到環境溫度時,氧氣在濃度過高時會被捕獲,無法在該溫度下形成穩定的溶液,從而形成超飽和狀態。當加熱到讓氧有一定流動性的溫度時,間隙氧(OI)傾向於從矽中以SiOx的形式沉澱出來。
置換碳可能形成這些沉澱物(SiOx)開始積累的中心。當氧氣從溶液中逸散出來時,它會形成電活性缺陷,會影響這些晶圓製品的特性。從理論上講,某些類型的氧沉澱物可以“吸收”重金屬雜質。若能將這些雜質從晶圓製品中清除,就能獲高品質的晶圓。
時至現今,許多技術已被用於監測間隙氧(OI)的濃度,和矽晶圓中置換碳(CS)的濃度。這些技術如氣體聚變分析、質譜分析、帶電粒子分析和中子活化分析,這些都是數於破壞性的量測,成本昂貴且相當耗時。因為它們都是檢測元素碳和氧的方法,所以它們是非特異性的,如果碳或氧以任何其他形式存在,則可能會偵測不到。矽和這些雜質之間形成的化學鍵結,能利用傅立葉轉換紅外光譜技術(FTIR)進行分析,紅外光譜沒有上述的缺點,並且對矽中的間隙氧(OI)和置換碳(CS)的濃度,進行非常專一性的量測監控。

圖2. Nicolet iS50 FTIR(MappIR)矽晶圓量測裝置
傅立葉轉換紅外光譜於晶圓量測間隙氧及置換碳的濃度
矽原子與晶格結構中的碳原子 (Si-C) 和氧原子 (Si-O-Si) 形成鍵結。紅外光譜使用波長(2-25 μm)的光照射樣品。矽對這些波長是透明的,當光穿過樣品時,與波長共振的化學鍵可以吸收一部分光。吸收的光量與形成鍵的原子濃度成正比,因此可以建立檢量線(Stand Curve)用於定量濃度。在紅外光譜技術中,用X軸單位使用cm-1,將波長表示為波數頻率更為方便顯示。在這些紅外吸收光譜中,間隙氧(OI)吸收集中在 1107 cm-1,置換碳(CS)吸收集中在 605 cm-1,如圖3所示。
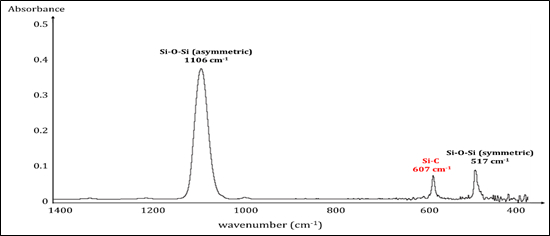
圖3. 間隙氧(OI)及置換碳(CS)於紅外光譜上的吸收位置
矽晶圓的矽-矽晶格鍵結(Si-Si)也會在紅外光譜上產生了一些獨特的吸收。這些已經將間隙氧以及置換碳(CS)都去除掉,純化過的矽晶圓。這紅外光譜的吸收度便可以用於測定磊晶(EPI)的厚度,如圖4所示。
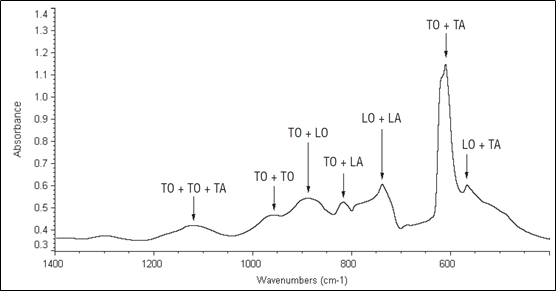
圖4. 光譜上的標記為矽中不同的晶格振動。
TA = 橫向聲學,TO = 橫向光學,LA = 縱向聲學以及LO = 縱向光學
FZ(Float Zone)精煉法,是透過將矽錠經過不同溫度區域的鑄爐,來進行純化的。在這些區域中,矽被加熱到接近熔化,並且這些區域沿著矽錠移動,便會將現行移動的雜質“掃”到晶體的某一端集中。該過程重複操作幾次便以提高矽的純度。真空浮區(VFZ)方法在真空中執行該過程以幫助去除氣態雜質。利用這兩種方法中,反覆執行越多次,雜質的濃度就跟著越低。
因為置換碳(CS)的吸收發生在與來自矽晶格的最強吸收相同的位置,所以需要FZ 矽光譜圖做為參考,見圖5。矽的 TO + TA 聲子(有時稱為“雙聲子帶”)集中在630 cm-1處,並且由於較低的訊噪比(S/N)使測量變得困難,在這個光譜區域存在的碳濃度相對較低。存在於1118 cm-1氧區域(TO + TO + TA 或“三聲子帶”)中的聲子強度要小得多。這種吸收在間隙氧(OI) 峰下方產生非線性的基線,並利用FZ矽參考光譜圖進行光譜相減,見圖6。
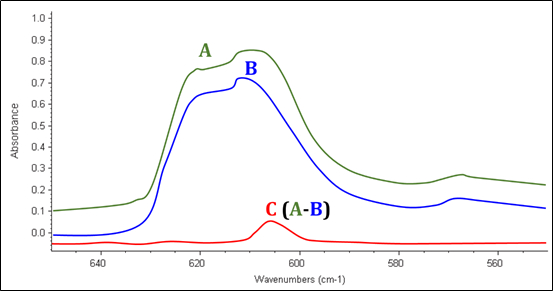
圖5. 顯示置換碳(CS)區域的矽光譜之碳吸收特性:
(A)含1 ppmA碳的光譜;(B)FZ矽的參考光譜;(C)光譜相減的結果。
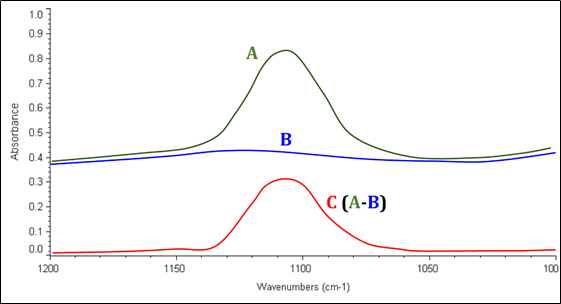
圖6. 顯示間隙氧(OI)區域的矽光譜之氧吸收特性:
(A)含30 ppmA氧的光譜;(B)FZ矽的參考光譜;(C)光譜相減的結果。
根據Beer’s Law我們可以得到當光徑(樣品厚度)固定時,即吸收度與濃度會成一線性關係,如下公式。

該方程式解釋,對於已知光徑(樣品厚度),濃度和吸光度之間存在線性關係,如圖7所示。若忽略雜質水平不計,矽濃度的遞增與光譜吸收度被認為是一致的,便可以使用該光區帶計算磊晶(EPI)厚度,如圖8所示。
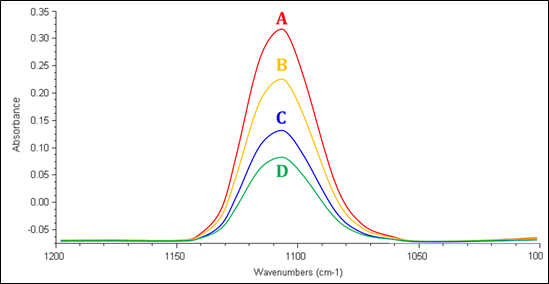
圖7. 顯示間隙氧(OI)各不同濃度的紅外光譜:
(A)含40 ppmA氧的光譜;(B)含30 ppmA氧的光譜;
(C)含20 ppmA氧的光譜;(D)含15 ppmA氧的光譜。
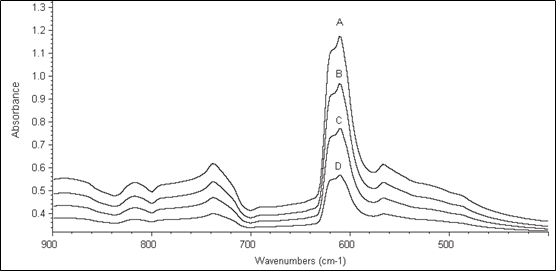
圖8. 顯示各不同厚度的晶圓紅外光譜:
(A)2.0 mm厚度的光譜;(B) 1.5 mm厚度的光譜;
(C) 1.0 mm厚度的光譜;(D) 0.5 mm厚度的光譜。


